Оцените презентацию от 1 до 5 баллов!
Тип файла:
ppt / pptx (powerpoint)
Всего слайдов:
14 слайдов
Для класса:
1,2,3,4,5,6,7,8,9,10,11
Размер файла:
277.00 kB
Просмотров:
64
Скачиваний:
0
Автор:
неизвестен
Слайды и текст к этой презентации:
№1 слайд
Содержание слайда: Правила проектирования и проектные нормы КМДП транзисторов
Тимошенко Александр Геннадиевич
Лекция 3
№2 слайд
№3 слайд
Содержание слайда: Подложка – легированный кремний одного типа
(для n-МОП легирование бором (p-тип примеси), для p-МОП легирование фосфором (n-тип примеси))
Подложка – легированный кремний одного типа
(для n-МОП легирование бором (p-тип примеси), для p-МОП легирование фосфором (n-тип примеси))
Сток-исток – сильнолегированный кремний другого типа
Подзатворный диэлектрик – оксид или нитрид кремния (SiO2 или Si3N4)
Затвор – поликристаллический кремний (Si*)
Изолирующие слои – толстый оксид кремния
Соединительный слой – металл
№4 слайд
Содержание слайда: Выращивание кристалла Si
Выращивание кристалла Si
Нарезка пластин Si
Механическая полировка
Химическая полировка
Ионная имплантация глубоких областей
Выращивание эпитаксиального слоя
Формирование кармана
Выращивание окисла
Фотолитография
№5 слайд
Содержание слайда: Нанесение фоторезиста
(Фоторезист – вещество, меняющее свои свойства при воздействии определенного рода излучений)
Нанесение фоторезиста
(Фоторезист – вещество, меняющее свои свойства при воздействии определенного рода излучений)
Фотолитография
Ионная имплантация фосфором
Удаление фоторезиста
№6 слайд
№7 слайд
Содержание слайда: Плазмохимическое травление
Плазмохимическое травление
Удаление фоторезиста
№8 слайд
Содержание слайда: Формирование тонкого подзатворного окисла
Формирование тонкого подзатворного окисла
Выращивание поликристаллического кремния
Создание активных областей транзистора (самосовмещенная технология)
№9 слайд
Содержание слайда: Легирование бором/фосфором высокой концентрации (p+/n+), прямо через поликристаллический кремний и тонкий окисел
Легирование бором/фосфором высокой концентрации (p+/n+), прямо через поликристаллический кремний и тонкий окисел
Диффузия n- и p- областей
(разгон примесей)
№10 слайд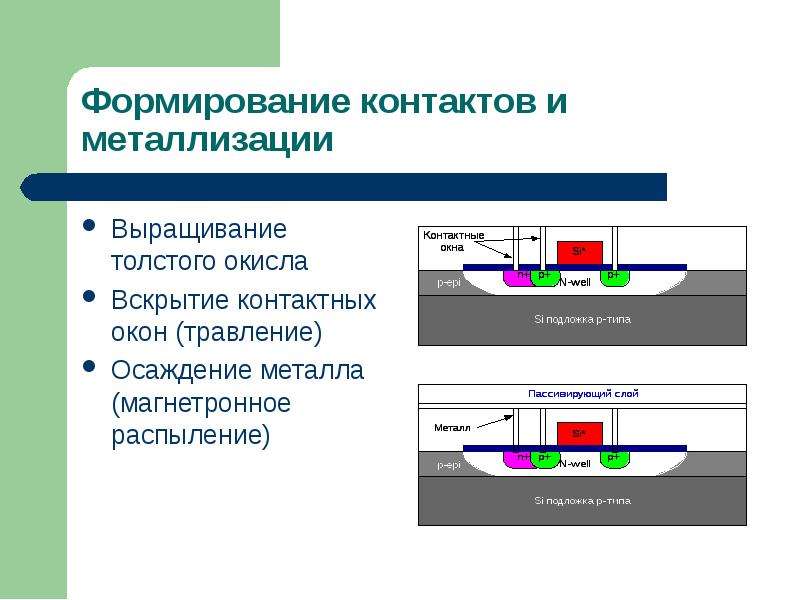
Содержание слайда: Выращивание толстого окисла
Выращивание толстого окисла
Вскрытие контактных окон (травление)
Осаждение металла (магнетронное распыление)
№11 слайд
№12 слайд
Содержание слайда: λ – норма проектирования равная половине технологического размера
λ – норма проектирования равная половине технологического размера
Минимальный размер области n-кармана неограничен
Минимальное расстояние между карманами неограниченно
Минимальная ширина тонкого окисла – 2λ
Минимальная ширина p+ и n+ областей – 4λ
Минимальный зазор между диффузионными областями – 4λ
Перекрытие n-канальным карманом области p-канального транзистора – 6λ
Минимальная ширина канала транзистора – 4λ
№13 слайд
Содержание слайда: Минимальная длина затвора транзистора – 2λ
Минимальная длина затвора транзистора – 2λ
Вылет (хвост) затвора на фоновый окисел – 2λ
Минимальная ширина поликремниевой шины вне активной области – 2λ
Размер поликремния в месте контакта – 6λ
Размер контактного окна – 2λ
Зазор между окнами – 5λ
Зазор между металлом в одном слое – 4λ
Минимальная ширина металлической шины – 4λ
№14 слайд
Содержание слайда: А1 = 2λ
А1 = 2λ
А2 = 2λ
А3 = 5λ
А4 = 1λ
L ≥ 2λ
W ≥ 4λ